‘X-Cube’ 복수의 칩을 적층해 하나의 반도체로 만드는 기술
후공정 경쟁력↑…“‘반도체 비전 2030’ 달성에 큰 역할 기대”
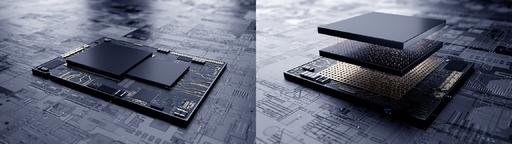 |
[세계비즈=김진희 기자] 삼성전자가 업계 최초로 7나노 EUV 시스템반도체에 3차원 적층 패키지 기술인 ‘X-Cube(eXtended-Cube)’를 적용한 테스트칩 생산에 성공했다고 13일 밝혔다.
이로써 삼성전자는 최첨단 EUV 초미세 전공정뿐 아니라 후공정에서도 첨단 기술 경쟁력을 확보하게 됐으며, 이는 ‘반도체 비전 2030’을 달성하는데 큰 역할을 할 것으로 기대된다.
X-Cube는 전공정을 마친 웨이퍼 상태의 복수의 칩을 위로 얇게 적층해 하나의 반도체로 만드는 기술이다. 시스템반도체는 일반적으로 CPU·GPU·NPU 등의 역할을 하는 로직 부분과 캐시메모리 역할을 하는 SRAM(Static Random Access Memory) 부분을 하나의 칩에 평면으로 나란히 배치해 설계한다.
X-cube 기술은 로직과 SRAM을 단독으로 설계·생산해 위로 적층하기 때문에 전체 칩 면적을 줄이면서 고용량 메모리 솔루션을 장착할 수 있어 고객의 설계 자유도를 높일 수 있다. 또한, 실리콘관통전극(TSV) 기술을 통해 시스템반도체의 데이터 처리속도를 획기적으로 향상시킬 수 있고, 전력 효율도 높일 수 있다.
이 외에도 위아래 칩의 데이터 통신 채널을 고객 설계에 따라 자유자재로 확장할 수 있고, 신호 전송 경로 또한 최소화할 수 있어 데이터 처리 속도 극대화할 수 있다는 장점이 있다.
삼성전자는 해당 기술이 슈퍼컴퓨터·인공지능·5G 등 고성능 시스템반도체를 요구하는 분야는 물론 스마트폰과 웨어러블 기기의 경쟁력을 높일 수 있는 핵심 기술로 활용될 것이라 예상한다.
글로벌 팹리스 고객은 삼성전자가 제공하는 X-Cube 설계방법론과 설계툴을 활용해 EUV 기술 기반 5, 7나노 공정 칩 개발을 바로 시작할 수 있다. 특히 이미 검증된 바 있는 삼성전자의 양산 인프라를 이용할 수 있기 때문에 개발 오류를 빠르게 확인하며 칩 개발 기간을 줄일 수 있다.
강문수 삼성전자 파운드리사업부 마켓전략팀 전무는 “EUV 장비가 적용된 첨단 공정에서도 TSV 기술을 안정적으로 구현해냈다”며 “삼성전자는 반도체 성능 한계 극복을 위한 기술을 지속 혁신해 나가겠다”고 말했다.
한편 삼성전자는 오는 16일부터 18일까지 온라인으로 진행되는 HPC·AI 등의 고성능 반도체 관련 연례 학술 행사인 ‘핫 칩스(Hot Chips) 2020’에서 X-Cube의 기술 성과를 공개할 계획이다.
purple@segye.com
ⓒ 세상을 보는 눈, 세계일보
이 기사의 카테고리는 언론사의 분류를 따릅니다.
기사가 속한 카테고리는 언론사가 분류합니다.
언론사는 한 기사를 두 개 이상의 카테고리로 분류할 수 있습니다.
언론사는 한 기사를 두 개 이상의 카테고리로 분류할 수 있습니다.


