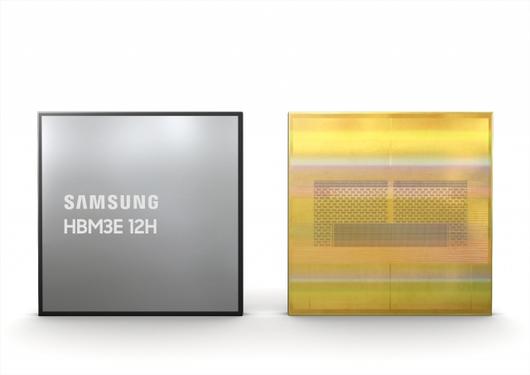 |
<이미지를 클릭하시면 크게 보실 수 있습니다> |
[디지털데일리 배태용 기자] AI 시장의 급속한 성장으로 핵심 부품인 HBM(고대역폭메모리) 수요도 폭발적으로 증가하고 있다. 늘어난 주문량에 주요 메모리 기업들이 HBM 생산을 확대에 나섰는데, 일각에선 공급 과잉 우려도 나오고 있다.
다만 메모리 기업들은 지금의 AI 시장의 성장 흐름을 고려했을 때, 앞으로도 지금과 같은 공급자 중심의 시장 흐름이 지속될 것으로 전망한다. 이에 케파(CAPA 생산능력)와 수율은 앞으로도 도전 과제로 남을 것으로 전망된다.
6일 메모리 업계 등에 따르면, 지난해 챗GPT의 등장으로 AI 시장이 본격적으로 열린 이후, 엔비디아, AMD 등 기업들을 중심으로 HBM 주문량은 급격히 늘고 있다. HBM은 이들 기업이 생산하는 GPU(그래픽처리장치) 등 AI 반도체에 필수적으로 들어가는 메모리다.
수요에 비해 공급량을 급격히 늘리기 어려운 특성상 수급이 불균형을 이루며 가격도 크게 뛰었다. 시장조사업체 욜그룹에 따르면 올해 들어 HBM 평균 판매단가가 기존 DDR4 D램과 비교해 500% 수준의 프리미엄이 더해져 판매되고 있는 것으로 나타났다.
고부가가치 상품 HBM 중심으로 삼성전자, SK하이닉스 등 메모리 기업들이 실적 개선을 이루면서 케파도 늘리려는 모습이다. 삼성전자는 올해 1분기 삼성전자의 설비투자(CAPAX) 규모는 11조3000억원으로, 지난해 1분기 대비 6000억원 늘렸다. 전체 설비투자 가운데 9조7000억원은 반도체 부문에 쏟아 부었다. AI 메모리로 주목받고 있는 HBM과 DDR5 공정 전환에 설비투자를 집중한 것으로 나타났다.
올해 HBM 공급 규모는 지난해 대비 3배 이상 늘릴 방침이라고 밝혔다. 김재준 삼성전자 메모리사업부 전략마케팅실장 부사장은 "올해 HBM 공급 규모는 비트(bit) 기준 전년 대비 3배 이상 지속해서 늘려가고 있고, 내년에도 올해 대비 최소 2배 이상의 공급을 계획하고 있다"라고 밝혔다.
SK하이닉스도 늘어나는 AI 향 메모리 수요에 대응하기 위해 약 20조원을 투자, 신규 D램 생산기지 팹(Fab) 청주 M15X를 건설을 추진한다. 중장기적으로 용인 반도체 클러스터, 미국 인디애나 어드밴스드 패키징 공장 등 미래 투자도 차질 없이 진행할 계획이다.
 |
<이미지를 클릭하시면 크게 보실 수 있습니다> |
이로 인해 올해 투자 규모도 연초 계획 대비 다소 증가할 것으로 보인다. 이에 대해 SK하이닉스는 "고객 수요 증가 추세에 따라 투자를 확대하기로 한 것이며, 이를 통해 HBM뿐 아니라 일반 D램 공급도 시장 수요에 맞춰 적절히 늘려갈 것"이라고 설명했다.
주목되는 점은 이러한 케파 확대 움직임에 따라 업계에 안팎에선 공급과잉 우려도 지속해서 제기되고 있는 것이다. 이에 대해 곽노정 SK하이닉스 대표이사 사장은 '그럴 일 없을 것'이라고 일축했다. 그는 "HBM은 기존 코모디티(Commodity·상품)와는 다르다. HBM4 이후가 되면 커스터마이징(고객 맞춤형) 니즈가 증가하면서 수주형 비즈니스 성격으로 옮겨갈 것이다"라며 "과잉 공급에 대한 리스크가 줄어들 것"이라고 내다봤다.
HBM 시장의 미래는 단순한 수요와 공급의 균형을 넘어서, 생산 비용을 최적화하고, 수율 등 고객 요구에 맞춘 맞춤형 제품을 적기에 공급하는 능력의 싸움이 될 것이라는 의미다. 삼성전자와 SK하이닉스는 서로 다른 HBM 제작 방식을 채택해 이러한 니즈를 충족시키려 하고 있다.
삼성전자는 TC-NCF(비전도성 접착 필름) 방식을, SK하이닉스는 MR-MUF(매스리플로몰디드언더필) 방식을 활용하고 있다. 지금까지 어떤 방식이 수율이 더 높은지는 정확히 알려지지 않았다. 다만, 양사는 각자 서로의 방식이 우월하다고 내세우고 있다.
삼성전자 D램개발실 윤재윤 상무는 "HBM은 제품 세대별로 일정 이상의 두께를 넘어설 수 없어 많이 쌓을수록 코어다이의 두께는 얇아지게 된다"라며 "그러다 보면 칩의 휘어짐이나 깨짐 현상으로 조립 난도가 높아지고 열저항이 커지는 문제가 발생한다"고 지적했다. 하이닉스가 차용한 방식의 단점을 언급한 것이다.
이에 곽노정 SK하이닉스 사장은 "MR-MUF 기술이 하이스택(High Stack)에서 한계를 보일 수 있다는 의견이 있지만, 실제로는 그렇지 않다"라며 "이미 어드밴스드 MR-MUF기술로 이미 HBM3 12H 제품을 양산하고 있다"라고 반박했다.
이어 "어드밴스드 MR-MUF는 칩의 휨 현상 제어(Warpage control)에도 탁월한 고온.저압 방식으로 고단 적층에 가장 적합한 솔루션"이라며 "16단 구현까지 순조롭게 기술 개발 중"이라고 강조했다.
- Copyright ⓒ 디지털데일리. 무단전재 및 재배포 금지 -
이 기사의 카테고리는 언론사의 분류를 따릅니다.
기사가 속한 카테고리는 언론사가 분류합니다.
언론사는 한 기사를 두 개 이상의 카테고리로 분류할 수 있습니다.
언론사는 한 기사를 두 개 이상의 카테고리로 분류할 수 있습니다.


